SWIR相机实现1µm精度的键合对准标记检测
随着半导体器件微缩化与封装复杂度提升,晶圆/芯片键合中的亚微米级对准愈发困难。传统光学检测难以识别埋入式对准标记及次表层缺陷,影响良率与性能。短波红外(SWIR)成像提供无损解决方案,可穿透硅等材料实现清晰成像,精准完成对准与缺陷检测。

先进封装中的精密对准挑战
在TSV、混合键合及CoWoS等技术推动下,晶圆与芯片的精密键合成关键需求。多层堆叠结构(如HBM)要求对准精度达1µm级——此尺度下的任何偏移都会导致互连失效、性能下降与良率损失。
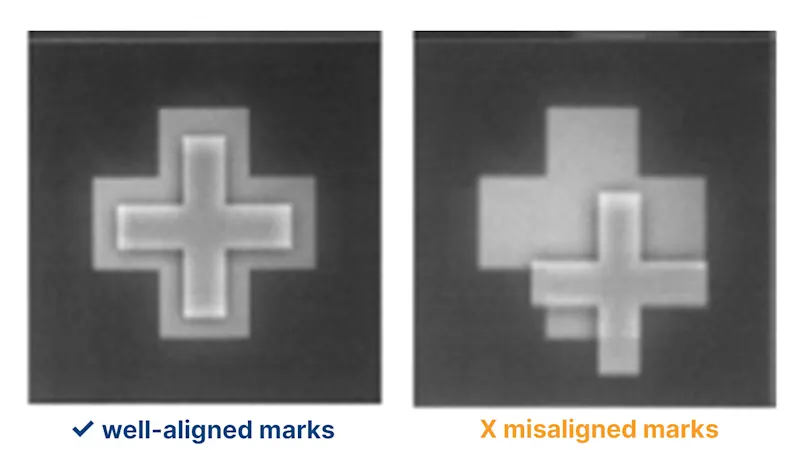
在晶圆和芯片键合过程中,确保精确对准和缺陷检测会带来一些挑战,这些挑战会影响产量和设备性能。这些挑战包括:
埋入标记显影:对准标记常被硅/氧化物/键合胶覆盖,传统光学系统无法穿透成像
高对比度要求:微弱标记与微缺陷需超高灵敏度与对比度才能精确识别
SWIR短波红外成像实现无损对准与缺陷检测
SWIR(短波红外)成像技术能够穿透硅材料及其他材质,在不损伤晶圆的前提下清晰呈现隐藏的对准标记和芯片键合界面。但要将该技术集成至高精度半导体检测设备,需攻克多项技术难点:
传感器选型:平衡灵敏度、成本与集成复杂度
InGaAs固有像素缺陷管理
主动冷却(TEC)的必要性判定
Basler 5.2MP SWIR相机的工业优化设计

Basler ace 2 X visSWIR系列相机填补了实验室级高性能制冷型短波红外(SWIR)相机与商用/公共安全领域低成本解决方案之间的技术空白。针对高端工业应用场景,该相机设计需实现三大核心平衡:在控制总体成本的同时确保所需检测精度,并实现与终端自动光学检测(AOI)设备的高度适配集成。
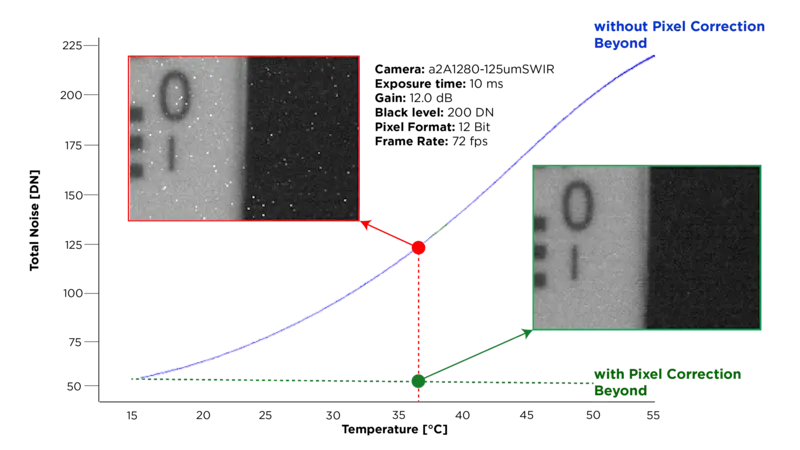
Basler ace 2 X visSWIR系列相机搭载索尼SenSWIR传感器,具备三大技术优势:
高对比度成像:精准识别微弱对准标记及亚表面缺陷
实时像素校正:动态补偿传感器瑕疵,输出无畸变高清图像
模块化散热系统:按需配置制冷方案,避免过度设计
不止于对准:SWIR成像技术赋能半导体检测
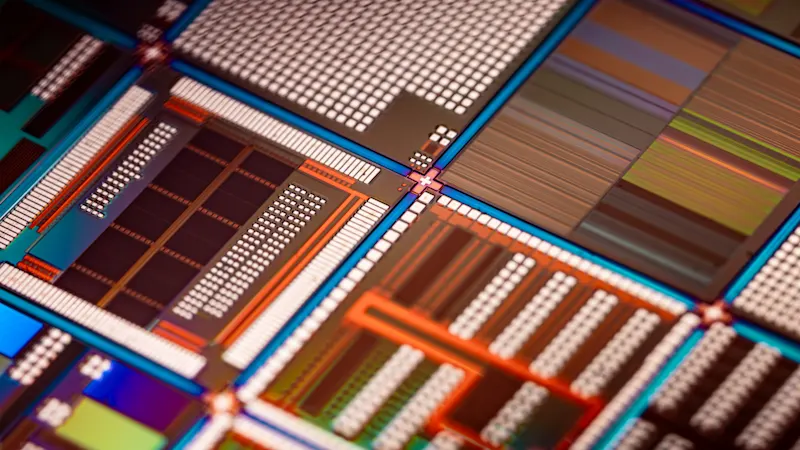
在晶圆键合与芯片对准之外,SWIR成像正深度赋能半导体检测全流程。其深层材料穿透能力与高对比度缺陷检测特性,可广泛应用于晶锭检测、缺陷分析、引线键合分析及良率提升等环节。SWIR相机通过穿透硅基材料实现多维度质量管控,贯穿半导体制造全周期。
SWIR成像:2.5D/3D先进封装的核心检测技术
凭借硅基材料穿透特性,SWIR成像技术正重塑半导体检测领域。从精密封装对准到缺陷识别与良率优化,其技术价值已得到充分验证。针对新一代2.5D与3D封装需求,SWIR成像已成为半导体设备商的实用视觉方案,可实现微米级对准精度与亚表面缺陷检测。
Basler不仅提供SWIR相机,更深度理解半导体检测痛点——以工程化思维打造检测系统,在确保纳米级精度的同时,避免过度设计,为高阶封装提供可靠保障。
该解决方案所用的产品
想实施类似的解决方案?这些产品将能助您一臂之力。



